 搜索到47條【TSV】相關的技術文章。
搜索到47條【TSV】相關的技術文章。
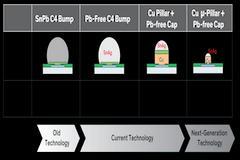




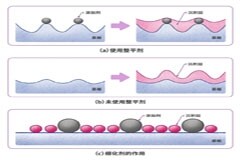

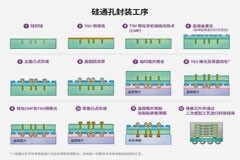

加載更多
 搜索到47條【TSV】相關的技術文章。
搜索到47條【TSV】相關的技術文章。